AI 芯片迈向 “晶圆级” 规模 DFT 成为良率生命线
从 2025 年主流芯片集成数百亿晶体管,到 Cerebras WSE 晶圆级芯片的 46,225mm² 超大面积(相当于 56 个英伟达 H100),AI 芯片正以 “指数级复杂度” 刷新行业认知。然而,尺寸与集成度的飙升带来了致命瓶颈 —— 良率断崖式下滑。目前,芯片缺陷密度显著增加,传统测试方法覆盖率不足,而 AI 芯片的异构集成架构、海量存储单元更让故障检测难上加难,直接导致研发成本飙升、量产周期拉长。
此时,DFT(可测性设计)技术不再是 “可选配置”,而是决定 AI 芯片商业化成败的核心支柱。它通过在设计阶段植入专用测试逻辑,让芯片具备 “自我体检” 能力,从源头解决测试效率、覆盖率与成本的矛盾。而新一代智能 DFT 分析工具,更将 AI 技术与 DFT 设计深度融合,为超大规模 AI 芯片提供全流程良率保障方案。
近日,广立微QuanTest-YAD良率感知大数据诊断分析平台在行业头部晶圆厂(Fab)完成功能和性能的双重认证,凭借卓越表现赢得高度认可,正式进入半导体制造的核心领域。
与此同时,QuanTest-YAD也在多家顶级芯片设计公司(Fabless)实现落地。YAD通过智能化诊断分析,连接芯片设计意图与量产制造结果,尤其适用于工艺严苛,设计复杂的大型芯片公司与追求极致性能与可靠性的AI芯片公司,为破解系统性良率瓶颈提供了关键工具。

QuanTest-YAD平台通过融合AI算法对全链路数据进行智能诊断,精准锁定失效根源并自动推荐分析方案,根因分析(RCA)准确率显著提升。同时,其工具性能显著优于业界标杆,能将原本耗时数周的复杂分析流程压缩至数小时,极大提升了效率。
QuanTest-YAD的价值不止于单点工具
它与广立微的DFT诊断入口、YMS良率管理系统以及Testchip测试芯片方案深度协同,构成了从设计预防、在线监控到失效诊断的完整闭环,提供生态化、系统化的良率提升解决方案,赋能客户构建智能制造与品控核心竞争力。
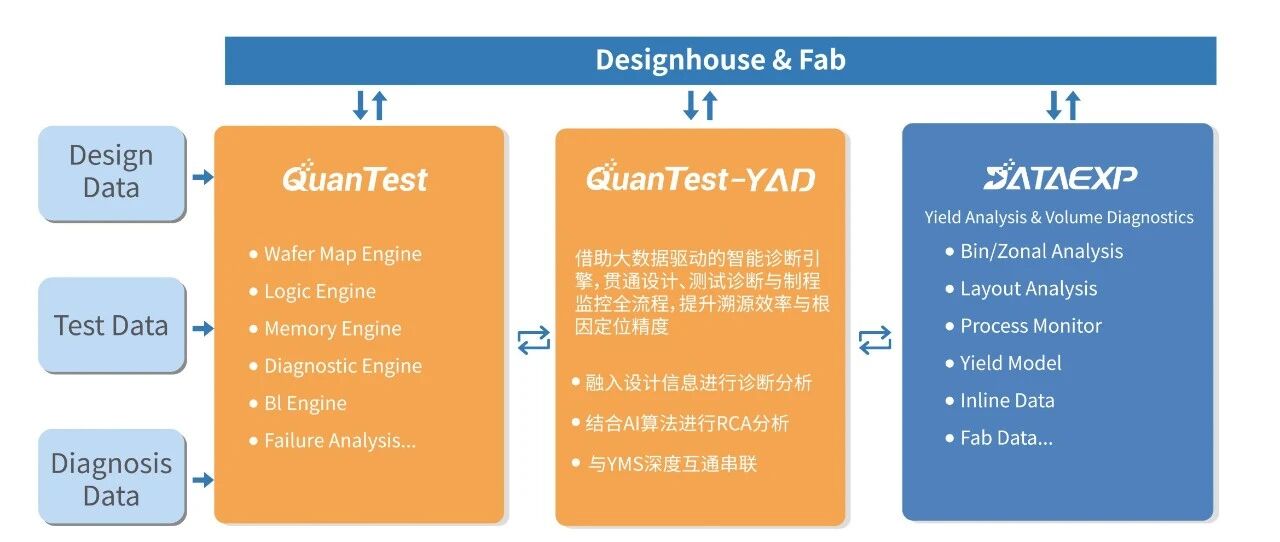
▲“DFT高效诊断+YAD智能分析”协同
全流程数据贯通
借助标准化数据技术,YAD支持适配主流DFT诊断报告进行良率诊断分析。通过有效结合电路物理设计签核(sign-off)数据,可帮助客户解决识别系统性时序及功耗失效根因问题。

此外,结合广立微DataEXP大数据平台,YAD可与YMS深度集成,串联芯片CP数据、Inline Metrology、WAT、Defect数据,形成芯片设计诊断到量产良率提升的闭环,实现多维度数据下钻分析。
智能化诊断分析
YAD通过数据挖掘和良率相关分析,融合先进AI算法模型,提供多种算法实现更准确的根因诊断分析(RCA, Root Cause Analysis)。此外,YAD可自动对Root Cause进行分组,通过RCA Trend看板展示每片Wafer的缺陷在物理层上的分布趋势,定位是否为已知问题。

结合缺陷的版图图形模式分析(LPA, Layout Pattern Analysis),支持识别出某些特定的版图图形,通过版图图形聚类功能及高度优化的自动化算法分析由版图图形模式造成的系统性失效根因,支持用户基于DFM hotspot库进行DFM-HIT分析。
YAD通过智能化诊断分析可精准定位在设计和制造端导致良率损失的系统性根因,并生成缺陷根因概率图,可智能推荐PFA候选项,方便用户快速定位问题。针对Memory诊断分析,YAD支持通过Bitmap分析寻找匹配的缺陷模式。
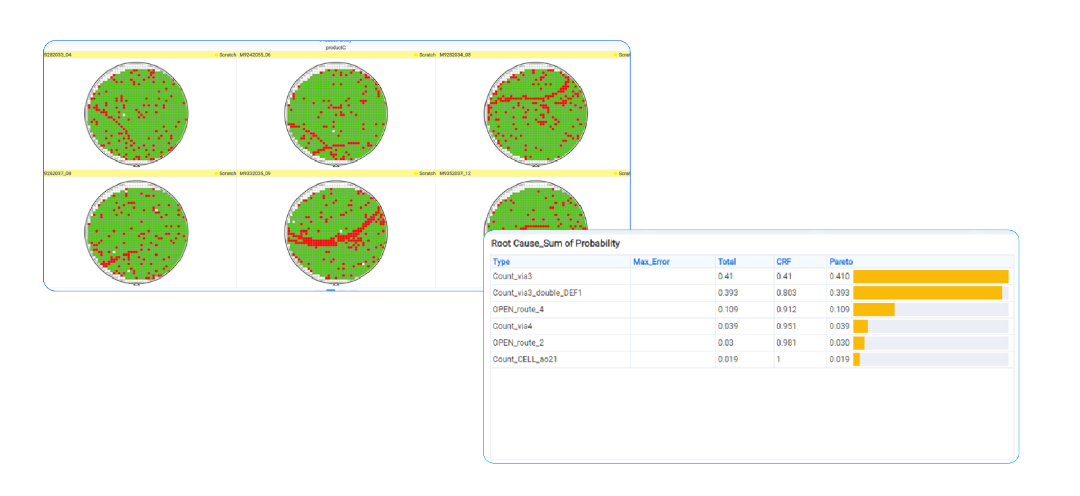
▲Wafer Pattern →RCA
广立微INF-AI大模型平台包含WPA、ADC、VM等智能化分析模块,YAD可以结合WPA进行晶圆空间模式分析,对Wafer进行Pattern聚类、分类、匹配分析,快速筛选特征Pattern数据进行根因诊断分析。
可视化交互与展示
YAD支持诊断报告可视化分析,用户可通过链接原始诊断报告,快速查看Defect物理信息及逻辑信息。Schematic view可将net细化为subnet,与Branch进行关联,进一步了解失效机理。YAD支持诊断报告可视化分析,提供与缺陷相关的电路图和布局信息,显著节省时间。通过直观的Wafer Map视图,灵活支持数据关联分析,帮助用户快速高效进行诊断分析。
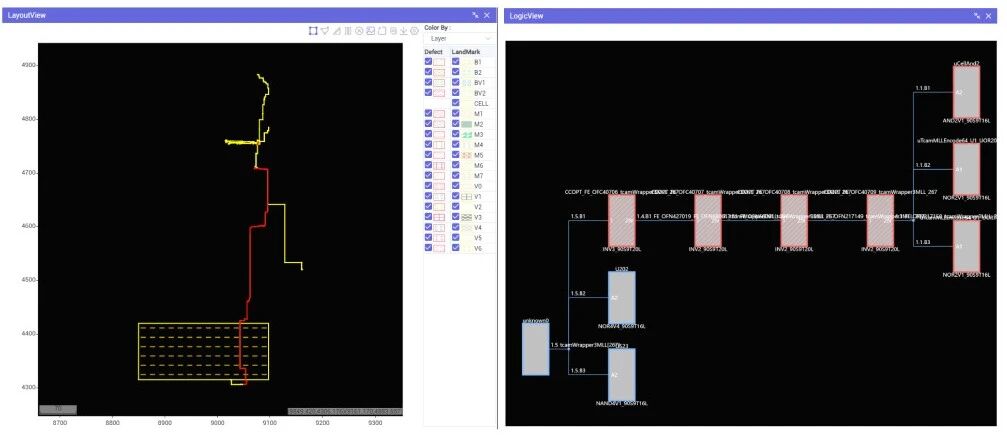
便捷PFA选取及PFA报告管理
YAD支持通过常规RCA分析、AI-RCA分析快速定位可能的失效根因,系统支持显示PFA路径,自动推荐最佳物理失效分析(PFA)候选者,显著提高PFA命中率,减少人工挑选的时间和成本。借助内置的广立微LayoutVision版图可视化工具,可全局显示缺陷的布局信息,并通过直观的图形化界面进一步追踪失效路径及分析其影响。
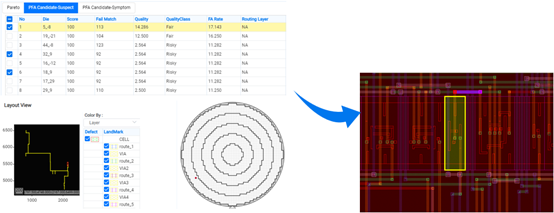
PFA History功能可智能关联Smart PFA Candidate,方便用户快速回传PFA报告,正确记录芯片失效原因及位置,并对历史PFA详情进行长期的趋势分析。

展望
面对日益复杂的系统性良率问题,数据智能与制造场景的深度融合将成为不可逆转的趋势。YAD全链路智能诊断连接芯片设计意图与量产制造结果,不仅是解决当下痛点的工具,更是驱动芯片制造实现高效智控与持续优化的核心引擎。










